反応性イオンエッチング(RIE)
反応性イオンエッチング(RIE)とは?
反応性イオンエッチングの概要
スパッタリング等で基板へ膜を生成しただけでは一面膜で覆われた状態になってしまいます。カメラのレンズに使用するための光のフィルターなどではこの状態で問題がないのですが、電子部品や半導体などはこの膜を利用して電気回路にして行く必要があります。例えば金属で作った膜に回路を描き、不要な部分を削り取ることで残った膜の部分が電気回路となることで微細な電気回路をつくることができます。この様に削り取る工程のことをエッチングと呼びます。
この不要な部分を削る方法として、昔は酸や薬液等で不要な部分を溶かすウェットエッチングと呼ばれる方法しかなかったのですが、この方法では集積化されたICやLSIの様な非常に細かい回路を作ることができませんでした。そこで真空中に入れた反応性のガスをプラズマにして加速したイオンをぶつけることで削って行くと同時に、
プラズマによって発生する粒子を化学反応させることによってエッチングを阻止する保護膜を生成し、不必要な部分がエッチングされることを防ぐことで非常に微細な加工を可能にした反応性イオンエッチング(Reactive Ion Etching = RIE)が登場しました。薬液をつかわない、つまり液体が無く乾燥した状態でのエッチングとなるためこれらはドライエッチングと呼ばれています。
ドライエッチングのメカニズムや様々な材料でのエッチング方法や、エッチング装置についてなど幅広く説明されています。専門的な内容になることからドライエッチングについて詳しく書かれた本は少ないのですが、この本ではメカニズムが理解しやすく説明されているだけでなく、実務経験豊富な筆者ならではの視点で非常に参考になる内容が書かれています。初めて関わるひとだけでなく経験の豊富なエンジニアの方にもお勧めです。
反応性イオンエッチングの特徴
エッチングにおいて、膜の削れかたの性質を表す言葉として等方性エッチングと異方性エッチングがあります。等方性エッチングとはプラズマにさらされている物質がさらされている部分の上下左右どの方向からもエッチングされることを言います。一方異方性エッチングとはプラズマに晒されている物質が一定の方向にのみエッチングされることを言います。
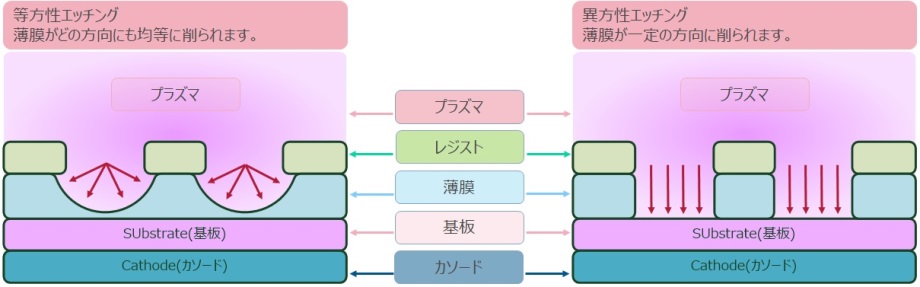
酸や薬液等によるウェットエッチングを行った場合や通常のプラズマエッチングでは、等方性のエッチングが行われるため削りたい物質に対して一定の方向以外からもエッチングされてしまうことから非常に細かい回路などを作りたい場合に、必要な部分まで削られてしまうため微細な加工を行うことができません。
しかし反応性イオンエッチングでは化学的な反応によってエッチングされたときに化合して発生する生成物である反応生成物や粒子によって飛び出したレジストが、エッチングされたくない箇所に堆積することにより保護膜となることでエッチングを阻止します。そのため必要な部分が削られることを防ぎ一定の方向にのみエッチングを行う「異方性エッチング」が可能になります。
反応性イオンエッチングのレジスト
反応性イオンエッチング(RIE)の仕組みを説明する前にまずレジストと呼ばれる物質を理解することが必要なため簡単にその機能を説明します。まずプラズマを利用したドライエッチングでは回路として残したい部分にフォトレジストと呼ばれるエッチングを防ぐための物質を付着させます。この物質が付着している部分はエッチングされない、つまり削りとられなくなるため薄膜を残したままにすることができます。
しかしフォトレジスト自体は塗布しただけではエッチングを防ぐ役割ははたしません。フォトレジストは光を照射した部分が感光して極性や分子量が変化することで初めてエッチングを防ぐ性質が現れる物質です。フォトレジストを塗布したあとでフォトマスクとよばれる残したい部分を透明にして光を通過させる様にした板をのせて、紫外線つまり光(photo)を照射することでエッチングを防ぎたい部分の形を基板に転写します。この様に光をあてた部分だけエッチングを防ぐ性質となるフォトレジストのことをネガ型レジストとよびます。
逆にもともとエッチングを防ぐ物質のものを塗布し、削りたい部分を透明にしたフォトマスクを使用して感光させることで極性や分子量を変化させてエッチングを防ぐ役割を無くすものもあります。この様に光をあてた部分だけッチングを防ぐ物質ではなくなり、エッチングされる様になる性質のフォトレジストのことをポジ型レジストと呼びます。

反応性イオンエッチングの仕組み
反応性イオンエッチング(RIE)の仕組みを見てゆきましょう。まずは「スパッタリングの基礎」で説明した理論を見て頂くと分かりやすいのですが、真空中に反応性ガスを投入し高周波電源等による電圧を利用してグロー放電によるプラズマを発生させます。するとそのプラズマ中では陽イオンや電子、またプラスイオンでもマイナスイオンでもない粒子の状態となったラジカルと呼ばれる中性の粒子が発生します。
するとプラズマ中にある陽イオンは基板側に発生している「VDC」によって引き付けられて基板のレジストやエッチングをしたい物資へ向かって加速されて真っ直ぐに衝突します。しかしこのとき発生している中性子(ラジカル)はプラスにもマイナスにも引き付けられることがないため熱運動によってさまざまな方向から基板に到達します。
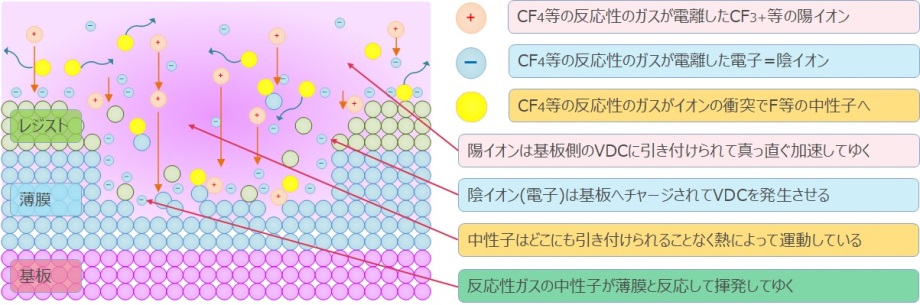
するとレジストがない部分では電離している反応性のガスやラジカルが基板の膜と化学反応して、反応による生成物つまり反応生成物を発生させます。しかし反応を防ぐ物質であるレジスト部分では化学反応は発生しません。このとき基板で発生した反応生成物が揮発性の物質の場合には反応した瞬間に基板表面から離れていってしまい基板表面からなくなってしまうため、また次の反応が基板表面で行われるのですが、不揮発性の反応生成物が発生する物質であった場合には反応生成物が基板上にのこってしまい保護膜となることで次の反応が行われなくなります。
しかしこのときに基板に衝突する陽イオンはエッチングをしたい物質だけではなくレジスト面にも衝突します。そのためレジストの粒子も空間に放出されるのですがこの粒子も基板側のVDCに引き付けられることによって再度基板に付着するのですが、エッチングされた部分の側壁を含め基板全体に付着することになります。しかしプラズマ中の陽イオンがさらに続けて上からまっすぐに衝突してくるため、エッチングしたい面に付着したレジストの粒子はすぐに再度空間にはじき出されてしまいます。

ここで衝突してくる陽イオンの物質は、VDCにひきつけられ加速しているため基板の真上の方向からのみ衝突するため、側壁に付着したレジストは弾き飛ばされることなく堆積してゆきます。そのため側面にはレジストによる保護膜が形成されプラズマ中に電離している反応性のガスやラジカルとの化学反応は行われない、つまり側壁はエッチングされることがなくなることから異方性エッチングが可能となります。